BGA封裝檢視原始碼討論檢視歷史
| BGA封裝 |
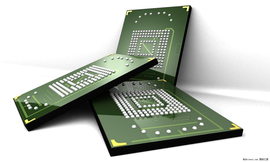 |
BGA封裝90年代隨着集成技術的進步、設備的改進和深亞微米技術的使用,LSI、VLSI、ULSI相繼出現,硅單芯片集成度不斷提高,對集成電路封裝要求更加嚴格,I/O引腳數急劇增加,功耗也隨之增大。為滿足發展的需要,在原有封裝品種基礎上,又增添了新的品種--球柵陣列封裝,簡稱BGA(Ball Grid Array Package)。
簡介
採用BGA技術封裝的內存,可以使內存在體積不變的情況下內存容量提高兩到三倍,BGA與TSOP相比,具有更小的體積,更好的散熱性能和電性能。BGA封裝技術使每平方英寸的存儲量有了很大提升,採用BGA封裝技術的內存產品在相同容量下,體積只有TSOP封裝的三分之一;另外,與傳統TSOP封裝方式相比,BGA封裝方式有更加快速和有效的散熱途徑。BGA封裝的I/O端子以圓形或柱狀焊點按陣列形式分布在封裝下面,BGA技術的優點是I/O引腳數雖然增加了,但引腳間距並沒有減小反而增加了,從而提高了組裝成品率;雖然它的功耗增加,但BGA能用可控塌陷芯片法焊接,從而可以改善它的電熱性能;厚度和重量都較以前的封裝技術有所減少;寄生參數(電流大幅度變化時,引起輸出電壓擾動)減小,信號傳輸延遲小,使用頻率大大提高;組裝可用共面焊接,可靠性高。
評價
隨着集成電路技術的發展,對集成電路的封裝要求更加嚴格。這是因為封裝技術關係到產品的功能性,當IC的頻率超過100MHz時,傳統封裝方式可能會產生所的"CrossTalk"現象,而且當IC的管腳數大於208 Pin時,傳統的封裝方式有其困難度。因此,除使用QFP封裝方式外,現今大多數的高腳數芯片(如圖形芯片與芯片組等)皆轉而使用BGA(Ball Grid Array Package)封裝技術。BGA一出現便成為CPU、主板上南/北橋芯片等高密度、高性能、多引腳封裝的最佳選擇。[1]